晶圓半導體量測儀器功能與應用綜合分析
摘要
本報告旨在對 Mitaka Kohki 的 NH-3SP 膜厚量測儀器進行深入分析,並與市場上其他具備類似功能的晶圓半導體量測儀器進行比較。報告內容涵蓋 NH-3SP 的核心功能、在半導體製程中的應用階段,以及各類儀器的技術原理、優勢、限制和應用場景。透過整合分析與視覺化呈現,提供對晶圓量測技術的全面理解。
1. Mitaka Kohki NH-3SP 膜厚量測儀器分析
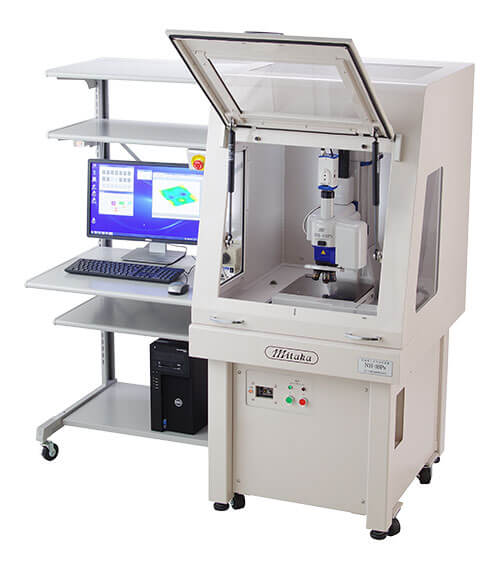
根據志隆儀器官網的資訊 ,Mitaka Kohki 的 NH-3SP 膜厚量測儀器主要用於 Step Height 量測,其核心功能與技術特點如下:
- Macro巨集程式化自動量測:具備自動量測晶圓表面線路膜厚、線寬、粗糙度的能力,並透過 Alignment Mark 自動辨識實現高度自動化。
- 影像與輪廓量測功能:可進行寬度、圓徑、中心點等影像量測,以及膜厚、線寬、PITCH、step height(階高)及粗度等輪廓量測。
- 非接觸式量測:採用點雷射自動聚焦技術,掃描樣品表面形貌與微結構輪廓,實現精準快速的自動化量測,且不會刮傷樣品表面,特別適合量測高深寬比的微結構輪廓。
- 高精度:搭載高精度光學尺,解析度可達 0.001um。
- 問題診斷:影像與輪廓量測的搭配,有助於在數據異常時快速判斷問題原因。
1.1 NH-3SP 在晶圓半導體製程中的應用階段
NH-3SP wafer 膜厚量測儀器在晶圓半導體製程中扮演關鍵的品質控制與製程監測角色,主要應用於以下階段 :
- 薄膜沉積 (Thin Film Deposition):精確量測介電層、金屬層或其他功能性薄膜的厚度與均勻性。
- 微影蝕刻 (Photolithography and Etching):量測線路線寬、蝕刻深度 (step height) 及粗糙度,確保圖案轉移的精確性。
- 化學機械平坦化 (Chemical Mechanical Planarization, CMP):量測 CMP 前後的階高 (step height) 變化,評估平坦化效果。
- 先進封裝技術 (Advanced Packaging):監測 AI 晶片、HPC 和 CoWoS 等複雜結構的 3D 表面形貌,確保製程穩定性與良率。
總體而言,NH-3SP 主要用於半導體製程中的前段製程 (FEOL) 和後段製程 (BEOL) 的多個關鍵檢測點,尤其在需要高精度非接觸式量測薄膜厚度、線寬、階高和表面形貌的環節。
2. 類似功能晶圓半導體量測儀器比較
市場上存在多種與 NH-3SP 功能類似的量測儀器,它們在技術原理、優勢和應用場景上各有不同。這些儀器主要分為階高與表面輪廓量測儀器和薄膜厚度量測儀器兩大類。
2.1 階高與表面輪廓量測儀器 (Step Height & Surface Profiling Instruments)
這類儀器主要用於量測晶圓表面微結構的高度、深度、粗糙度以及整體形貌,對於監控微影、蝕刻、薄膜沉積和 CMP 等製程至關重要 。
|
品牌
|
產品系列/型號
|
技術類型
|
主要功能與應用場景
|
優勢與限制
|
|
KLA Corporation
|
Alpha-Step D-500 / D-600 系列
|
探針式 (Stylus Profiler)
|
2D 階高、表面粗糙度、翹曲、應力等量測。廣泛應用於半導體、MEMS、光學等領域的製程監控 。
|
優勢:高垂直解析度 (奈米級甚至埃級),不受材料光學特性影響,可量測不透明或透明材料。 限制:接觸式量測可能刮傷樣品,量測速度相對較慢,不適合高深寬比結構的側面量測。
|
|
KLA Corporation
|
Zeta 系列 / Profilm3D
|
光學式 (Optical Profiler)
|
3D 表面形貌、階高、薄膜厚度、粗糙度等非接觸式量測。適用於晶圓、光罩、LED 等多種樣品 。
|
優勢:非接觸式、量測速度快、可進行 3D 掃描、不損傷樣品。 限制:對於透明或高反射材料可能存在量測挑戰,垂直解析度通常略低於探針式。
|
|
Bruker
|
Dektak 系列 (如 DektakXT)
|
探針式 (Stylus Profiler)
|
奈米級階高、表面粗糙度、薄膜應力、薄膜厚度等量測。在半導體研發與製造中用於精確的 3D 表面計量 。
|
優勢:高精度、高重複性、可靠性,可量測多種材料。 限制:與 KLA Alpha-Step 類似,存在接觸式量測的潛在風險和速度限制。
|
|
Bruker
|
ContourX 系列
|
白光干涉儀 (White Light Interferometry, WLI)
|
非接觸式 3D 表面形貌、階高、粗糙度、薄膜厚度等量測。特別適用於晶圓、光學元件、精密機械零件等 。
|
優勢:非接觸、高精度 3D 量測、速度快、可量測大面積。 限制:對樣品表面反射率和透明度有要求,不適用於所有材料。
|
|
Taylor Hobson
|
Form Talysurf 系列
|
探針式 (Stylus Profiler)
|
精密輪廓、表面粗糙度、波紋度、形狀誤差等分析。在半導體、汽車、航空航太等高精度製造領域應用廣泛 。
|
優勢:極高精度和穩定性,可提供詳細的表面幾何資訊。 限制:接觸式量測,速度較慢,主要針對 2D 輪廓分析。
|
|
Keyence (基恩斯)
|
VK-X 系列 (雷射掃描共聚焦顯微鏡) / VR 系列 (3D 測量顯微鏡)
|
雷射掃描 / 光學
|
3D 輪廓、階高、粗糙度、體積、面積等自動量測。適用於各種材料和形狀的樣品,包括晶圓、電子元件等 。
|
優勢:非接觸、高解析度 3D 影像與量測、操作簡便、多功能性。 限制:對於極高深寬比結構或特定光學特性材料可能存在量測盲區。
|
|
Mitaka Kohki (三鷹光器)
|
NH 系列 (如 NH-3SP)
|
點雷射自動聚焦 (Point Laser Autofocus)
|
非接觸式 3D 形貌、階高、膜厚、線寬、PITCH、粗度等量測。特別適合晶圓表面線路膜厚、線寬和階高量測 。
|
優勢:非接觸、高精度、可量測高深寬比微結構、自動化程度高。 限制:量測速度可能受限於點掃描方式,對於超大面積的快速掃描可能不如光學干涉儀。
|
2.2 薄膜厚度量測儀器 (Thin Film Thickness Measurement Instruments)
這類儀器專注於精確量測晶圓上沉積的各種薄膜的厚度,對於製程控制和產品性能至關重要 。
|
品牌
|
產品系列/型號
|
技術類型
|
主要功能與應用場景
|
優勢與限制
|
|
KLA Corporation
|
SpectraFilm / Aleris 系列
|
橢圓偏振儀 (Ellipsometry)
|
先進薄膜厚度、光學常數 (n, k)、材料組成等量測。廣泛應用於半導體前段和後段製程的薄膜監控 。
|
優勢:極高精度,可量測極薄膜 (奈米級甚至埃級),非接觸、非破壞性。 限制:設備成本高,對樣品表面平整度有要求,模型建立較複雜。
|
|
Onto Innovation
|
Atlas 系列
|
橢圓偏振儀 / 反射式光譜
|
高產出薄膜量測、關鍵尺寸 (OCD)、材料特性分析。在先進製程中與 KLA 競爭,提供高精度和高通量的解決方案 。
|
優勢:高通量、高精度、整合 OCD 量測,在特定應用中具競爭力。 限制:與橢圓偏振儀的普遍限制相似。
|
|
Horiba
|
UVISEL 系列
|
橢圓偏振儀
|
多層薄膜厚度、光學常數、材料組成、介面特性等分析。適用於研發和生產環境 。
|
優勢:功能全面,可分析複雜多層薄膜結構,提供豐富的材料資訊。 限制:設備成本和操作複雜度較高。
|
|
Otsuka Electronics (大塚電子)
|
FE 系列
|
反射式光譜 (Reflectometry)
|
非接觸式薄膜厚度分布量測。適用於透明或半透明薄膜的厚度監控。
|
優勢:量測速度快、操作相對簡單、成本較低。 限制:不適用於不透明薄膜,對薄膜光學特性有要求,精度可能略低於橢圓偏振儀。
|
|
Filmetrics (KLA 子公司)
|
F20 / F50 系列
|
反射式光譜
|
桌面型或自動化薄膜厚度量測。適用於研發、品質控制和生產線監控。
|
優勢:易於使用、性價比高、量測速度快。 限制:與反射式光譜儀的普遍限制相似。
|
3. 視覺化分析
3.1 晶圓量測技術性能對比雷達圖
下圖展示了不同量測技術在「解析度 (垂直)」、「量測速度」、「非接觸性」、「3D 形貌能力」和「成本效益」等方面的性能對比。NH-3SP (點雷射) 在非接觸性和 3D 形貌能力方面表現突出,同時兼顧了較高的解析度。
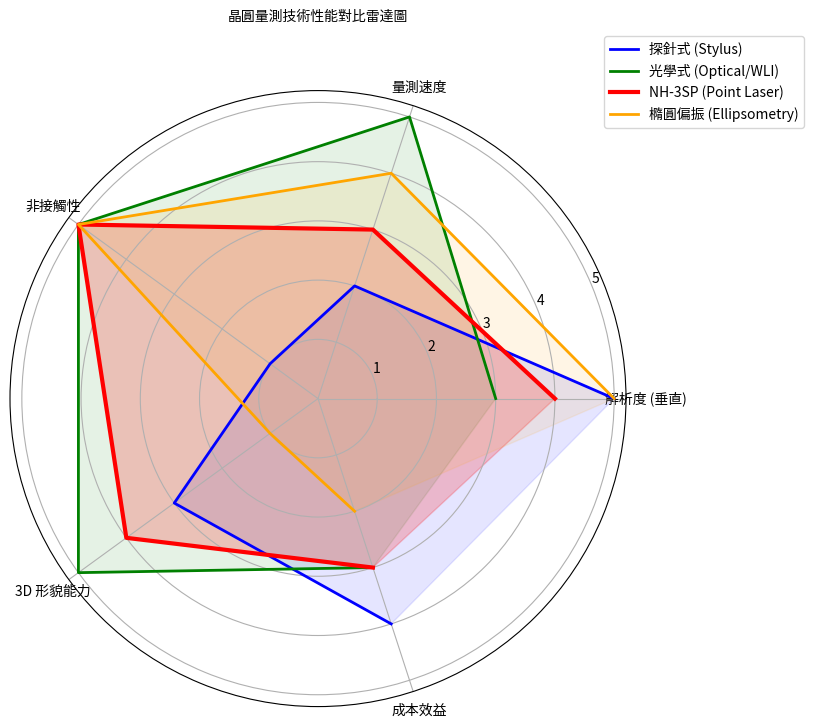
3.2 半導體製程階段之量測儀器適用性對比
下圖比較了 NH-3SP 系列儀器與業界平均/其他儀器在半導體製程各階段的適用性評分。NH-3SP 在蝕刻、CMP 和先進封裝等階段展現出較高的適用性,尤其在先進封裝方面表現優異。

4. 結論
Mitaka Kohki 的 NH-3SP 膜厚量測儀器作為一款非接觸式點雷射自動聚焦儀器,在晶圓半導體製程中,特別是在需要高精度階高、膜厚和表面輪廓量測的環節,具有顯著優勢。其非接觸性、高精度和對高深寬比微結構的量測能力,使其在微影蝕刻、CMP 和先進封裝等關鍵製程中扮演重要角色。
與其他市場上的競爭產品相比,NH-3SP 介於傳統探針式和光學式儀器之間,結合了兩者的優點。探針式儀器提供極高垂直解析度但速度慢且有接觸風險;光學式儀器則非接觸、速度快,但對樣品光學特性有要求。橢圓偏振儀則專注於極薄膜的超高精度量測。
最終儀器的選擇應基於具體的應用需求,包括所需的量測精度、速度、樣品特性、預算以及製程階段。對於需要非接觸、高精度階高和表面輪廓量測的應用,NH-3SP 及其類似的光學/雷射掃描儀器是理想的選擇。


Comments are closed